半导体制造中最重要的激光应用
通过我们的信息图表,直观了解激光技术在半导体制造中的关键作用——从硅晶体到成品微芯片。在前端工艺中,激光可用于晶圆切割、曝光、蚀刻、掺杂和表面平坦化,而精确的激光测量则可确保质量。在后端工艺中,激光可用于芯片的分离、连接、结构化加工和打标。这张图清楚地展示了芯片制造商如何在众多工艺中使用激光,将其作为实现超高精度、高效率和高质量的工具。
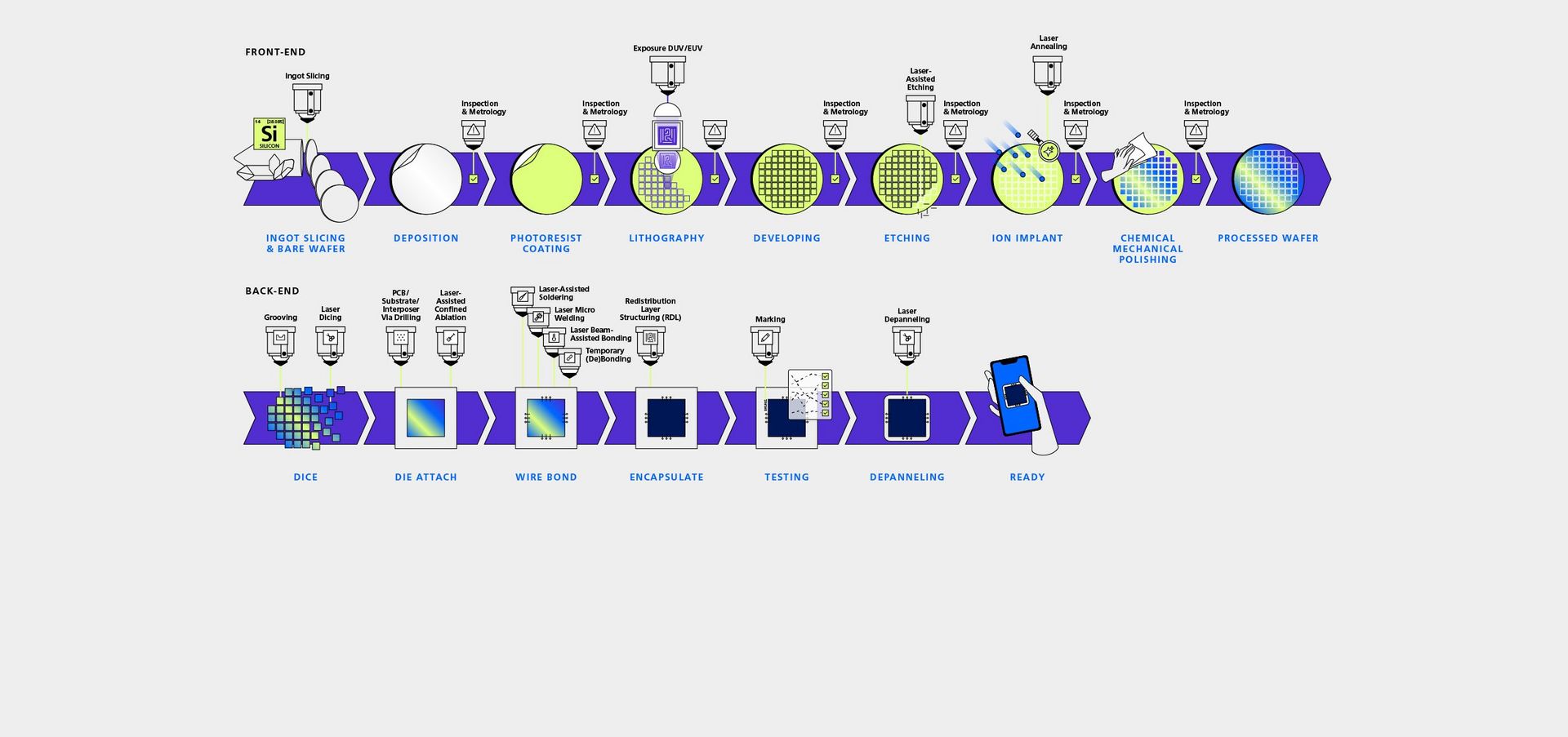
1. 晶锭切片
激光以尽可能减少材料损伤的方式,将硅单晶切割成极薄的晶圆。
2. 检测与计量
在晶圆厂的几乎每道工序之后,非接触式激光测量和缺陷检测都能保障质量并实现过程控制。
3. DUV/EUV 曝光
要为曝光过程提供深紫外(DUV)或极紫外(EUV)光,就需要激光。
4. 激光退火
激光会在几纳秒内选择性加热晶圆表面附近的区域。这有助于修复晶体缺陷并激活掺杂元素。
5. 激光辅助蚀刻
激光通过加热特定区域,加速局部蚀刻。这对于复杂结构尤其有帮助。
6. 开槽
激光可在晶圆或基板材料上切割出细微槽纹。这样可降低后续切割过程中的机械应力,并提高良率。
7. 激光切割
激光束可在不产生颗粒的情况下,将晶圆切割成单个芯片(晶粒)。激光工艺尤其适用于超薄晶圆。
8. PCB/基板/中介层通孔钻孔
激光可在印刷电路板、基板和绝缘层中钻出微小通孔(Via)。这些通孔可实现 3D 芯片中不同电路层之间的垂直连接。
9. 激光辅助受限消融
激光可定点去除表面材料,例如用于露出难以接触的触点。
10. 激光辅助焊接
激光加热微小的焊接点,从而连接芯片和载体元件。
11. 激光微焊接
激光束可对细丝进行局部熔化,从而焊接接触点。
12. 激光束辅助键合
激光通过定向热输入,为芯片与基板或封装外壳之间的热压键合做好准备。
13. 临时键合/解键合
激光可在加工过程中支持芯片与载体之间必要的临时键合(Bonding)和解键合(Debonding)。
14. 再分布层图案化(RDL)
激光可对负责将芯片信号传输至外部的薄金属层(再分布层)进行结构化加工,并将多个芯片连接在一起。
15. 打标
激光打标机可在芯片和封装外壳上标记序列号、二维码或标识。
16. 激光分离
激光束可将单个芯片、模块或印刷电路板组件从较大的拼板(Panel)中分离出来。

