A legfontosabb lézeralkalmazások a félvezető-gyártásban
Fedezze fel infografikánkat, amely a lézertechnológiák kulcsfontosságú szerepét szemlélteti a félvezetők gyártásában, a szilíciumkristálytól a kész mikrochipig. A front-endben lézerfolyamatok kísérhetik a lapkák vágását, expozícióját, marását, dotálását és simítását, míg a pontos lézeres mérések biztosíthatják a minőséget. A back-endben a lézerek gondoskodhatnak a chipek szétválasztásáról, összekapcsolásáról, strukturálásáról és jelöléséről. Az ábra szemlélteti, hogyan alkalmazhatják a chip-gyártók a lézereket számos folyamatban: szerszámként a maximális pontosság, hatékonyság és minőség érdekében.
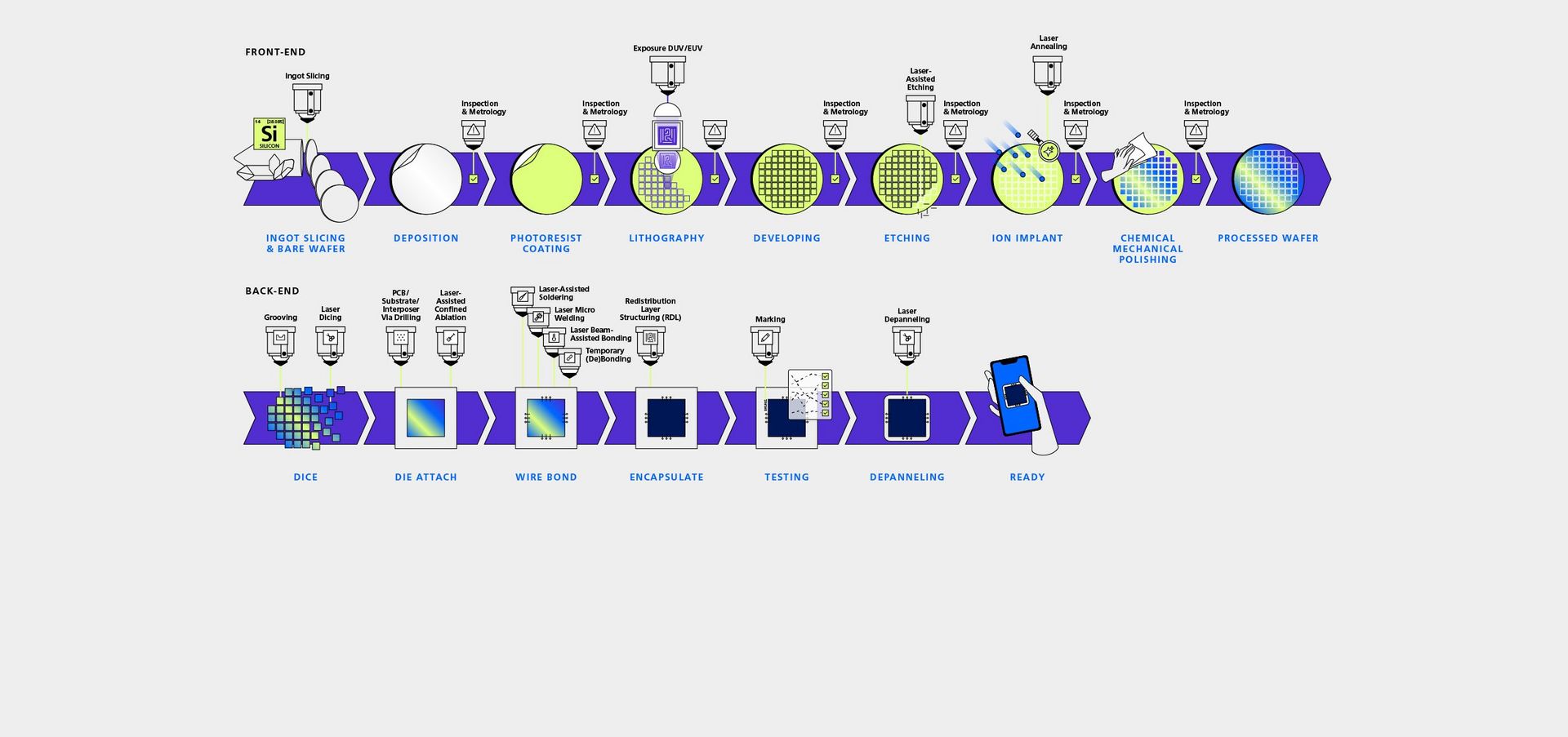
1. Ingot Slicing
Egy lézer anyagkímélő módon rendkívül vékony lapkákra vágja a szilícium monokristályt.
2. Inspection & Metrology
Az érintésmentes lézeres mérés és hibafelismerés biztosítja a minőséget és folyamatellenőrzést szinten minden munkalépés után a Foundry-ban.
3. Exposure DUV/EUV
A lézerek a mély ultraibolya (DUV) vagy szélsőséges ultraibolya (EUV) sugárzás rendelkezésre bocsátásához szükségesek az expozíciós folyamathoz.
4. Laser Annealing
A lézer pár nanoszekundum alatt szelektíven felmelegíti a lapka felületközeli tartományait. Ez helyrehozza a kristályhibákat és aktiválja a dotáló anyagokat.
5. Laser-Assisted Etching
A lézer felmelegít bizonyos területeket, hogy ott felgyorsítsa a helyi marást. Ez a komplex formáknál rendkívül hasznos.
6. Grooving
A lézer finom barázdákat (Grooves) vág a lapka és a szubsztrátum anyagába. Ez csökkenti a mechanikai stresszt az utólagos Dicing során és növeli a hozamot.
7. Laser Dicing
Egy lézersugár részecskementesen külön chipekre (Dies) vágja a lapkát. A lézersugaras eljárásokat rendkívül gyakran alkalmazzák a nagyon vékony lapkák esetén.
8. PCB/Substrate/Interposer Via Drilling
A lézerek apró átkötéseket (via) fúrnak a nyomtatott áramköri lapokba, a szubsztrátumokba és a szigetelőrétegekbe. A kapcsolási szintek függőleges összekapcsolását teszik lehetővé a 3D chipekben.
9. Laser-Assisted Confined Ablation
A lézer célzottan leválasztja a felületi anyagot, például a nehezen hozzáférhető érintkezési pontok szabaddá tételéhez.
10. Laser-Assisted Soldering
A lézer apró forrasztási helyeket melegít fel és ezáltal összeköti a chipet és a hordozó elemet.
11. Laser Micro Welding
A lézersugarak pontosan felolvasztják a finom drótokat és ezáltal összehegesztik az érintkezési pontokat.
12. Laser Beam-Assisted Bonding
A lézer előkészíti a chip és a szubsztrátum vagy a burkolat termokompressziós összeillesztését célzott hőbevitellel.
13. Temporary (De)Bonding
A lézer támogatja a chipek és hordozók szükséges időnkénti összekapcsolását (Bonding) vagy szétválasztását (Debonding) a feldolgozás során.
14. Redistribution Layer Structuring (RDL)
A lézer strukturálja a vékony fémréteget (Redistribution Layer), amely kifelé vezeti a jeleket a chipből, és összeköt több chipet egymással.
15. Marking
A jelölő lézerek sorozatszámokat, Data Matrix kódokat vagy logókat visznek fel chipekre és burkolatokra.
16. Laser Depanneling
A lézersugár leválasztja a külön chipeket, modulokat vagy a nyomtatott áramköri lapok komponenseit egy nagyobb kombinációból (panel).

