半導體製造中最重要的雷射應用
透過我們的資訊圖表,直觀了解雷射技術在半導體製造中的關鍵作用——從矽晶體到成品微晶片。在前段製程中,雷射可用於晶圓切割、曝光、蝕刻、摻雜和平坦化處理,而精確的雷射測量則可確保品質。在後段製程中,雷射可用於晶片的分離、連接、結構化加工和標註。這張圖清楚展示了晶片製造商如何在眾多製程中使用雷射,將其作為實現超高精度、高效率和高品質的工具。
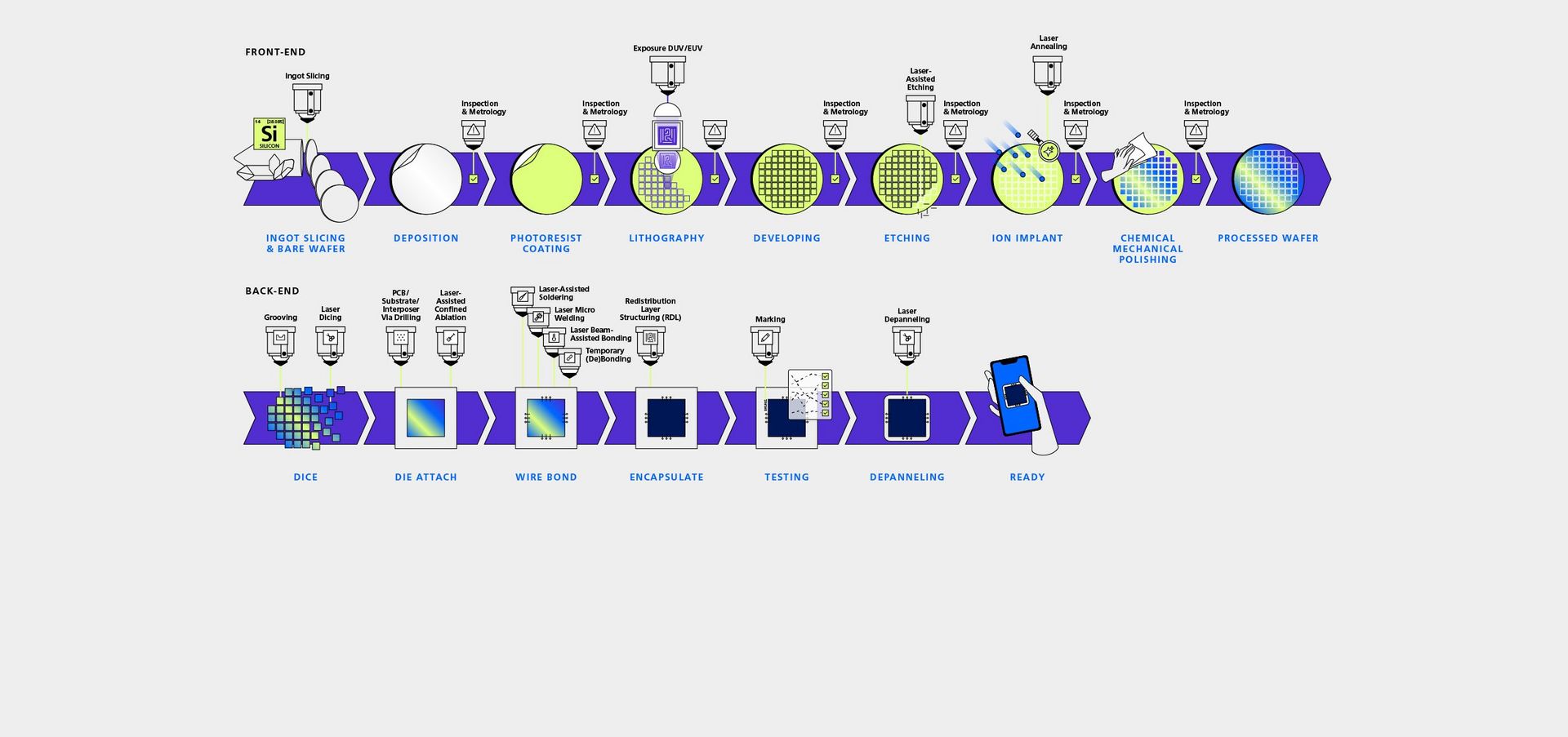
1. 晶錠切片
雷射以盡可能減少材料損傷的方式,將矽單晶切割成極薄的晶圓。
2. 檢測與計量
在晶圓廠的幾乎每道製程之後,非接觸式雷射測量和缺陷檢測都能保障品質並實現製程控制。
3. DUV/EUV 曝光
要為曝光過程提供深紫外(DUV)或極紫外(EUV)光,就需要雷射。
4. 雷射退火
雷射會在幾奈秒內選擇性加熱晶圓表面附近的區域。這有助於修復晶體缺陷並活化摻雜元素。
5. 雷射輔助蝕刻
雷射透過加熱特定區域,加速局部蝕刻。這對於複雜結構尤其有幫助。
6. 開槽
雷射可在晶圓或基板材料上切割出細微槽紋。這樣可降低後續切割過程中的機械應力,並提高良率。
7. 雷射切割
雷射束可在不產生顆粒的情況下,將晶圓切割成單個晶片(晶粒)。雷射製程尤其適用於超薄晶圓。
8. PCB/基板/中介層通孔鑽孔
雷射可在印刷電路板、基板和絕緣層中鑽出微小通孔(Via)。這些通孔可實現 3D 晶片中不同電路層之間的垂直連接。
9. 雷射輔助受限消融
雷射可定點去除表面材料,例如用於露出難以接觸的接點。
10. 雷射輔助焊接
雷射加熱微小的焊接點,從而連接晶片和載體元件。
11. 雷射微焊接
雷射束可對細絲進行局部熔化,從而焊接接觸點。
12. 雷射束輔助鍵合
雷射透過定向熱輸入,為晶片與基板或封裝外殼之間的熱壓鍵合做好準備。
13. 臨時鍵合/解鍵合
雷射可在加工過程中支援晶片與載體之間必要的臨時鍵合(Bonding)和解鍵合(Debonding)。
14. 再分布層圖案化(RDL)
雷射可對負責將晶片訊號傳輸至外部的薄金屬層(再分布層)進行結構化加工,並將多個晶片連接在一起。
15. 標註
雷射雕刻機可在晶片和封裝外殼上標註序號、二維碼或標識。
16. 雷射分離
雷射束可將單個晶片、模組或印刷電路板元件從較大的拼板(Panel)中分離出來。

