Cele mai importante aplicații laser în producția de semiconductori
Descoperiți infograficul nostru care arată clar rolul cheie al tehnologiilor laser în fabricarea semiconductorilor, de la cristalul de siliciu la microcipul finit. În faza preliminară, procesele laser pot însoți debitarea, iluminarea, gravarea, dopajul și netezirea waferelor, în timp ce măsurătorile laser precise pot asigura calitatea. În faza finală, laserele pot fi utilizate pentru a separa, conecta, structura și inscripționa cipurile. Ilustrația arată clar modul în care producătorii de cipuri pot utiliza laserele în numeroase procese: ca un instrument pentru precizie, eficiență și calitate maxime.
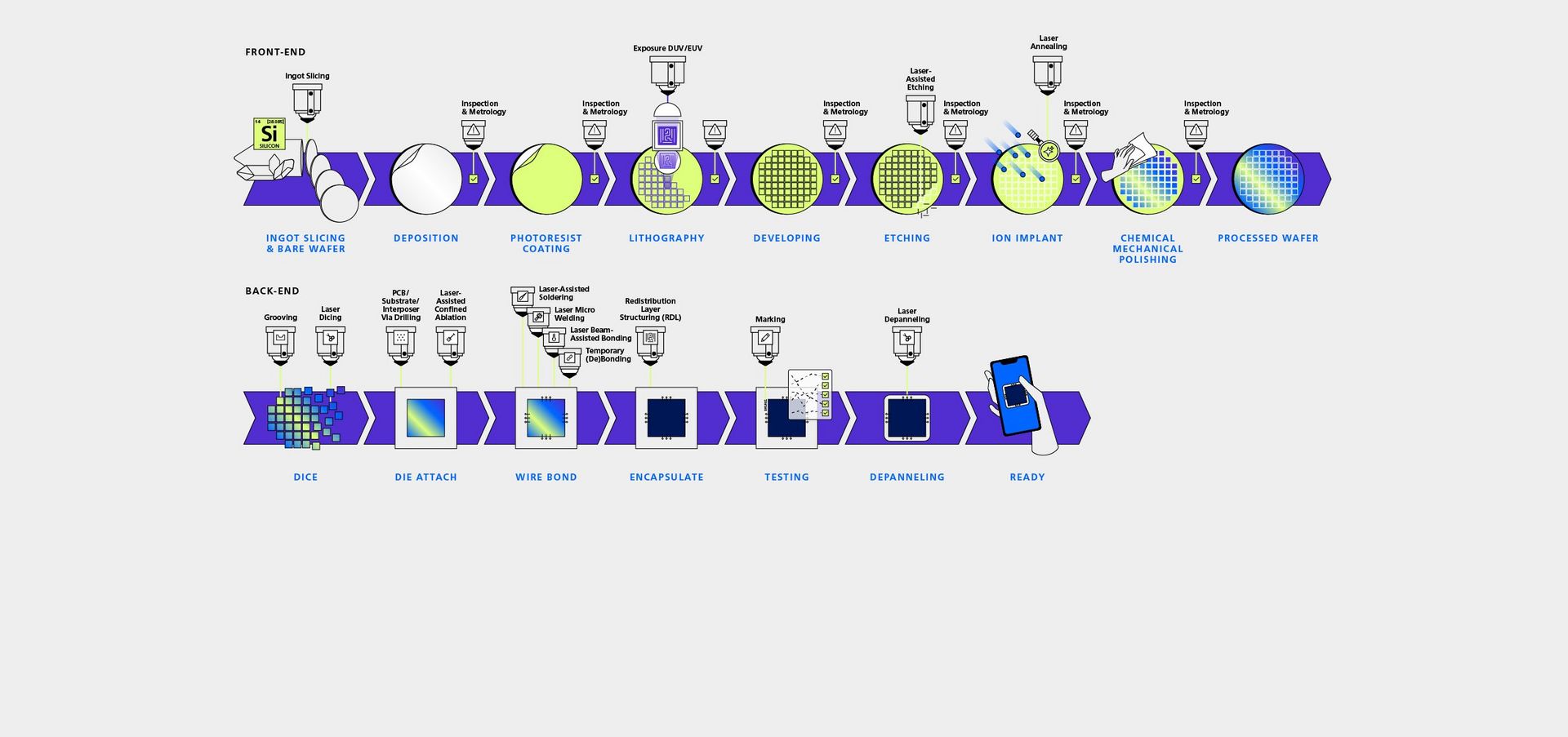
1. Tăierea lingourilor
Un laser taie ușor cristalul unic de siliciu în wafere extrem de subțiri.
2. Inspecție și metrologie
Măsurarea laser fără atingere și detectarea defectelor asigură controlul calității și al procesului după aproape fiecare etapă de lucru în turnătorie.
3. Expunere DUV/EUV
Laserele sunt necesare pentru a furniza radiații ultraviolete profunde (DUV) sau ultraviolete extreme (EUV) pentru procesul de iluminare.
4. Recoacere cu laser
Laserul încălzește selectiv zonele de pe wafer apropiate de suprafață pentru câteva nanosecunde. Acest lucru remediază defectele cristalelor și activează dopanții.
5. Gravare asistată cu laser
Laserul încălzește anumite zone pentru a accelera gravarea localizată. Acest lucru este deosebit de util pentru formele complexe.
6. Canelare
Laserul taie caneluri fine (grooves) în wafer sau în substratul de material. Acest lucru reduce stresul mecanic în timpul tăierii tip Dicing ulterioare și crește randamentul.
7. Tăiere tip Dicing cu laser
Un fascicul laser taie waferul în cipuri individuale (dies) fără nicio particulă. Procedeele laser sunt utilizate în special pentru wafere foarte subțiri.
8. PCB/substraturi/interposere prin perforare
Laserul perforează mici contacte pătrunse (vias) în plăci de circuit imprimat, substraturi și straturi izolante. Ele permit legături verticale ale nivelurilor de circuit în cipuri 3D.
9. Ablație confinată asistată cu laser
Laserul îndepărtează în mod specific materialul de suprafață, de exemplu pentru a dezveli punctele de contact greu accesibile.
10. Sudare asistată cu laser
Laserul încălzește micile puncte de lipire și conectează astfel cipul și elementul suport.
11. Micro-sudare cu laser
Fasciculele laser topesc fire fine în puncte specifice și astfel sudează punctele de contact.
12. Îmbinare asistată cu fascicul laser
Laserul pregătește îmbinarea termocompresivă a cipului și a substratului sau a carcasei prin pătrundere punctuală a căldurii.
13. (Dez)lipire temporară
Laserul asistă îmbinarea (Bonding) sau separarea (Debonding) temporară necesară a cipurilor și suporturilor în timpul procesării.
14. Structurarea stratului de redistribuire (RDL)
Laserul structurează stratul metalic subțire (stratul de redistribuire) care transportă semnalele de la cip la exterior și conectează mai multe cipuri între ele.
15. Inscripționare
Laserele de inscripționare aplică numere de serie, coduri Data Matrix sau sigle pe cip și carcasă.
16. Depanelare cu laser
Fasciculul laser separă cipurile individuale, modulele sau componentele PCB de un ansamblu mai mare (panel).

