Las aplicaciones láser más importantes en la fabricación de semiconductores
Descubra nuestra infografía en la que ilustramos con todo detalle el papel clave de las tecnologías láser en la fabricación de semiconductores, desde el cristal de silicio hasta el microchip acabado. En la fase inicial (front end), los procesos láser pueden acompañar el corte, la exposición láser, el marcado por abrasión, el dopado y el aplanado de las obleas, mientras que las mediciones láser precisas contribuyen a garantizar la calidad. En la fase final (back end), se pueden utilizar láseres para separar, conectar, estructurar y marcar los chips. La ilustración muestra claramente cómo los fabricantes de chips pueden utilizar el láser en un gran número de procesos: se trata de una herramienta excepcional para lograr la máxima precisión, eficiencia y calidad.
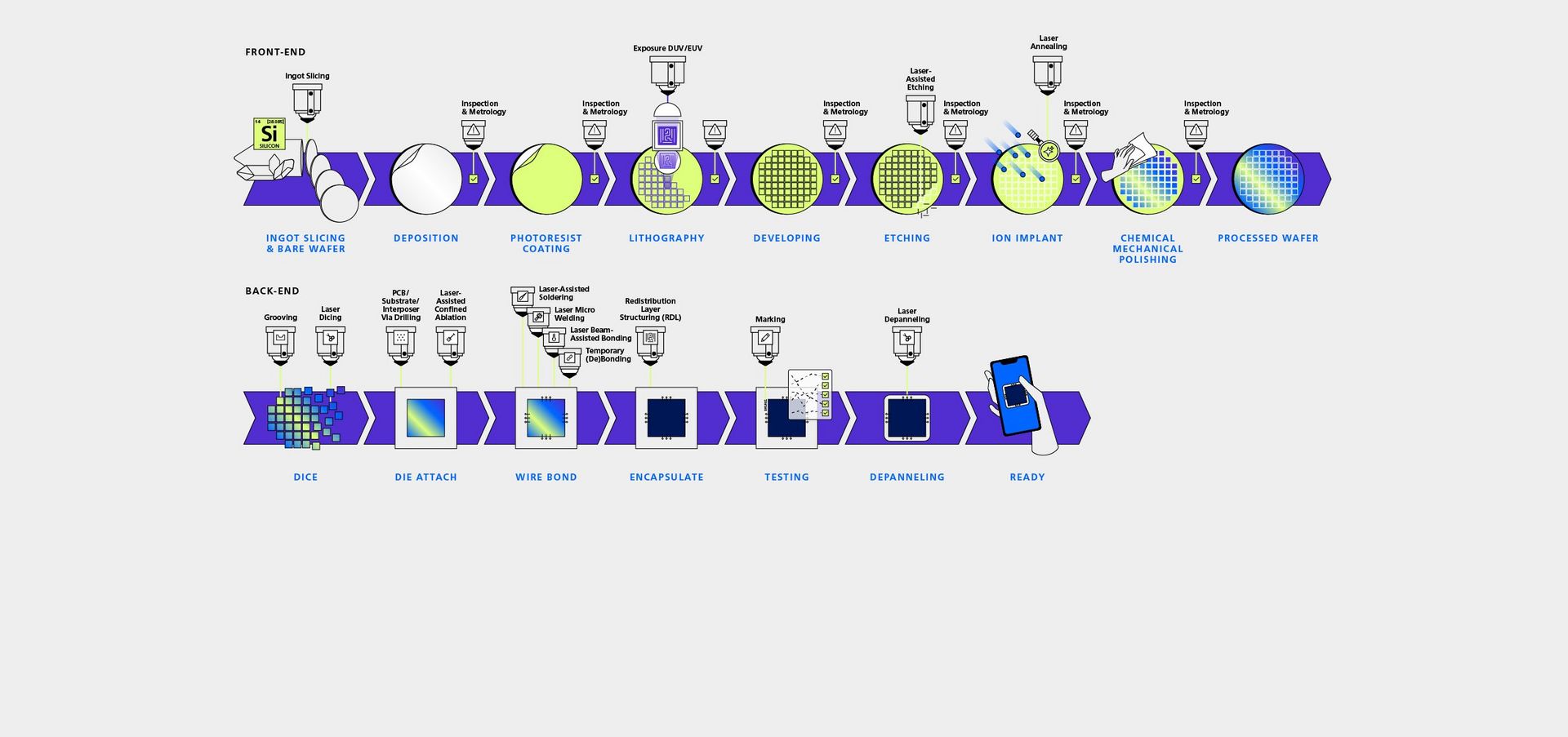
1. Corte de lingotes
Un láser corta el monocristal de silicio en obleas extremadamente finas protegiendo el material al mismo tiempo.
2. Inspección y metrología
La medición láser sin contacto y la detección de defectos garantizan la calidad y el control de procesos después de prácticamente cada paso de trabajo en la fundición.
3. Exposición DUV/EUV
Los láseres son imprescindibles para proporcionar radiación ultravioleta profunda (DUV) o ultravioleta extrema (EUV) para el proceso de exposición láser.
4. Recocido láser
En pocos nanosegundos el láser calienta de forma selectiva las áreas cercanas a la superficie de la oblea. Eso repara los defectos del cristal y activa los dopantes.
5. Grabado asistido por láser
El láser calienta áreas específicas para acelerar el marcado por abrasión de forma localizada. Esto es particularmente útil en caso de formas complejas.
6. Ranurado
El láser corta ranuras finas (grooves) en la oblea o el material del sustrato. Con ello se consigue reducir la tensión mecánica durante el corte posterior en dados y aumenta el rendimiento.
7. Corte en obleas por láser
Un haz láser corta la oblea en chips individuales (dados) con ausencia total de partículas. Los procesos láser se utilizan especialmente en el caso de obleas muy finas.
8. Perforación de vías pasantes de tarjeta de circuito impreso / sustrato / intercalador
El láser perfora diminutas vías de interconexión (Vias) en tarjetas de circuito impreso, sustratos y capas aislantes. Permiten conexiones verticales de planos de circuitos en chips 3D.
9. Ablación confinada asistida por láser
El láser elimina de forma selectiva material de la superficie, por ejemplo, para exponer puntos de contacto de difícil acceso.
10. Soldadura asistida por láser
El láser calienta minúsculas uniones de soldadura, conectando así el chip y el elemento portante.
11. Micro-soldadura láser
Los haces láser funden alambres finos en puntos específicos, soldando así puntos de contacto entre sí.
12. Unión asistida por haz láser
El láser prepara la unión termocompresiva de chip y sustrato o carcasa mediante un aporte de energía calorífica dirigido.
13. Unión/separación temporal
El láser favorece la unión (bonding) o separación (debonding) temporal necesaria de chips y soportes durante el procesamiento.
14. Redistribution Layer Structuring (RDL)
El láser estructura la fina capa de metal (Redistribution Layer) que transporta las señales desde el chip al exterior y conecta varios chips entre sí.
15. Marcado
Los láseres de marcado aplican números de serie, códigos Datamatrix o logotipos en el chip y la carcasa.
16. Separación de placas por láser
El haz láser separa chips, módulos o componentes de tarjetas de circuito impreso individuales a partir de un conjunto de mayor tamaño (panel).

