As principais aplicações do laser na fabricação de semicondutores
Descubra nosso infográfico, que mostra a função importante das tecnologias laser na fabricação de semicondutores, do cristal de silício até a o microchip pronto. No frontend os processos laser podem acompanhar o corte, exposição, corrosão, dopagem e alisamento do wafer, enquanto medições a laser precisas asseguram a qualidade. No backend, os lasers podem cuidar da separação, união, estruturação e marcação dos chips. A ilustração deixa claro como os fabricantes de chips podem usar lasers em diversos processos: como uma ferramenta para máxima precisão, eficiência e qualidade.
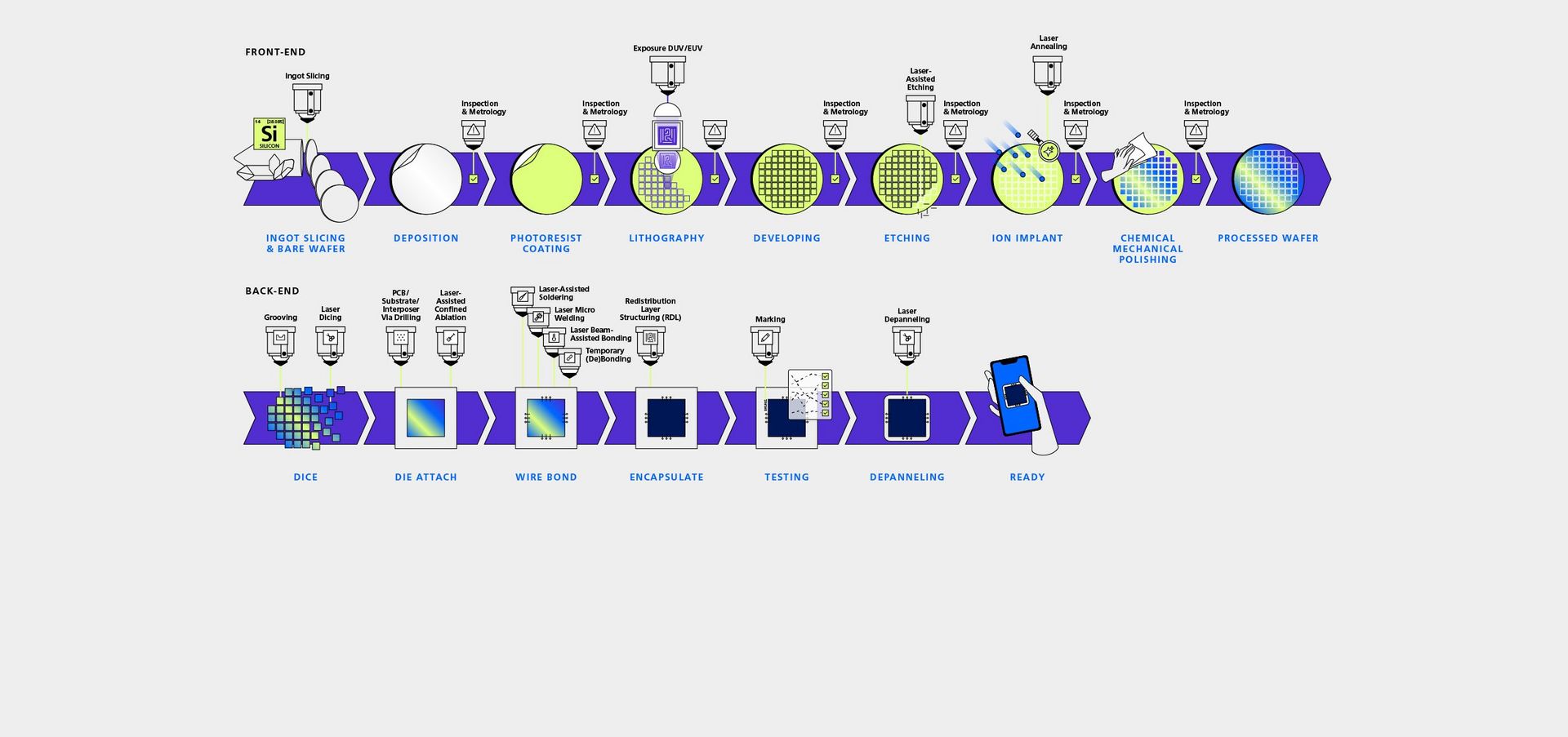
1. Ingot slicing
Um laser corta o cristal único de silício em wafers extremamente finos de forma a preservar o material.
2. Inspection & Metrology
A medição e detecção de erros a laser sem contato assegura a qualidade e o controle do processo após quase cada passo de trabalho na foundry.
3. Exposição UVP/UVE
Os lasers são necessários para fornecer radiação ultravioleta profunda (UVP) ou ultravioleta extrema (UVE) para o processo de exposição.
4. Laser annealing
O laser aquece seletivamente áreas do wafer próximas à superfície por alguns nanossegundos. Isso cura erros do cristal e ativa materiais de dopagem.
5. Laser assisted etching
O laser aquece determinadas áreas, para acelerar a corrosão local ali. Isso é especialmente útil nas formas complexas.
6. Grooving
O laser corta ranhuras finas (grooves) no wafer ou material de substrato. Isso reduz o estresse mecânico no dicing subsequente e aumenta o aproveitamento.
7. Laser dicing
Um feixe de laser corta o wafer em chips individuais (dies) sem partículas. Processos laser são aplicados com grande frequência em wafers muito finos.
8. PCI/Substrate/Interposer Via Drilling
Os lasers perfuram pequenos contatos (vias) em placas de circuito, substratos e camadas de isolação. Eles permitem conexões verticais de níveis de circuito em chips 3D.
9. Laser assisted confined ablation
O laser remove especificamente o material da superfície, por exemplo, para expor pontos de contato de difícil acesso.
10. Laser assisted soldering
O laser aquece pequenos pontos de solda, conectando assim o chip e o elemento substrato.
11. Microssolda a laser
Os raios laser fundem fios finos em pontos específicos e, assim, soldam os pontos de contato.
12. Laser beam assisted bonding
O laser prepara a união termocompressiva do chip e do substrato ou invólucro aplicando calor direcionado.
13. Temporary (de)bonding
O laser suporta a união (bonding) ou separação (debonding) temporária necessária de chips e substratos durante o processamento.
14. Redistribution layer structuring (RDL)
O laser estrutura a fina camada de metal (redistribution layer) que transporta sinais do chip para o exterior e conecta vários chips.
15. Marcação
Lasers de gravação aplicam números de série, códigos de matriz de dados ou logotipos em chips e invólucros.
16. Laser depanneling
O raio laser separa chips individuais, módulos ou componentes de placas de circuito de um conjunto maior (painel).

