Najważniejsze zastosowania laserów w produkcji półprzewodników
Zachęcamy do zapoznania się z naszą infografiką, która w przystępny sposób przedstawia kluczową rolę technologii obróbki laserowej w produkcji półprzewodników, od kryształu krzemu po gotowy mikroczip. W fazie początkowej procesy laserowe mogą towarzyszyć cięciu, naświetlaniu, wytrawianiu, domieszkowaniu i wygładzaniu wafli, podczas gdy precyzyjne pomiary laserowe mogą zapewnić jakość. W zapleczu produkcyjnym lasery mogą służyć do rozdzielania, łączenia, laserowego procesu strukturyzacji i znakowania chipów. Prezentacja jasno pokazuje, w jaki sposób producenci chipów mogą wykorzystywać lasery w wielu procesach: jako narzędzie zapewniające najwyższą precyzję, wydajność i jakość.
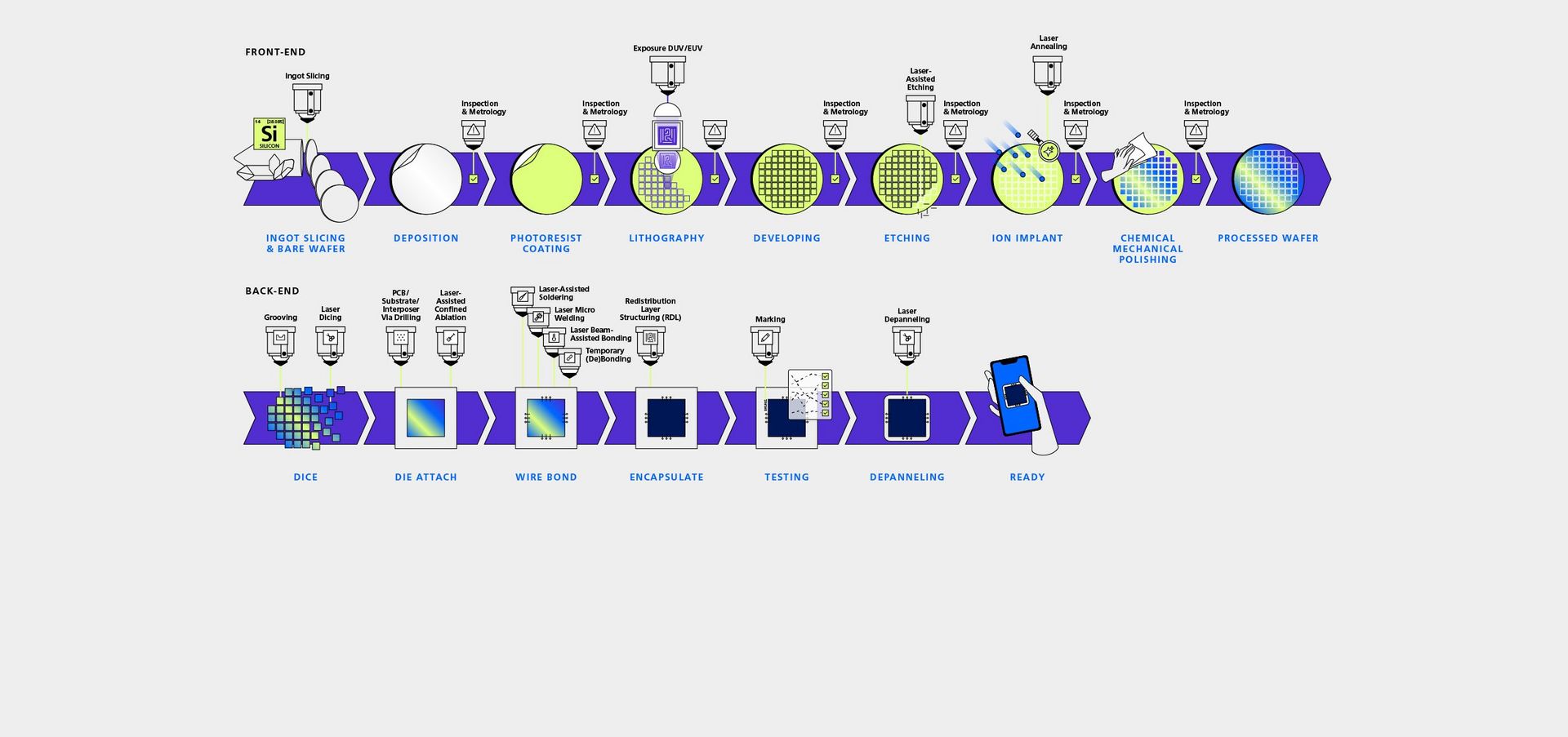
1. Ingot Slicing
Laser tnie monokryształ krzemu na niezwykle cienkie wafle, nie naruszając materiału.
2. Inspection & Metrology
Bezkontaktowe pomiary laserowe i wykrywanie błędów zapewniają kontrolę jakości i procesu po niemal każdej czynności w odlewni.
3. Exposure DUV/EUV
Lasery są niezbędne do zapewnienia promieniowania głębokiego ultrafioletu (DUV) lub ekstremalnego ultrafioletu (EUV) do procesu naświetlania.
4. Laser Annealing
Laser podgrzewa przez kilka nanosekund wybrane obszary powierzchniowe wafla. Naprawia to defekty kryształów i aktywuje domieszki.
5. Laser Assisted Etching
Laser podgrzewa określone obszary, aby przyspieszyć lokalne wytrawianie. Jest to szczególnie pomocne w przypadku złożonych kształtów.
6. Grooving
Laser wycina drobne rowki (grooves) w materiale waflowym lub podłożu. Zmniejsza to mechaniczne obciążenie podczas późniejszego cięcia i zwiększa wydajność.
7. Laser Dicing
Promień lasera tnie wafel bezpyłowo na pojedyncze chipy (matryce). Procesy laserowe są szczególnie często stosowane w przypadku bardzo cienkich wafli.
8. PCB / Substrate / Interposer Via Drilling
Lasery wiercą niewielkie połączenia przechodzące (vias) w płytkach obwodu drukowanego, podłożach i warstwach izolacyjnych. Umożliwiają one na przykład pionowe połączenia poziomów obwodów w chipach 3D.
9. Laser Assisted Confined Ablation
Laser przeprowadza precyzyjną obróbkę ubytkową, na przykład w celu odsłonięcia trudno dostępnych punktów styku.
10. Laser Assisted Soldering
Laser podgrzewa niewielkie miejsca lutowania, łącząc w ten sposób chip i element nośny.
11. Laser Micro Welding
Promienie lasera topią cienkie druty w określonych punktach, łącząc w ten sposób miejsca styku.
12. Laser Beam Assisted Bonding
Laser przygotowuje termokompresyjne łączenie chipa i podłoża lub obudowy poprzez precyzyjne dostarczanie energii cieplnej.
13. Temporary (De)Bonding
Laser wspomaga niezbędne tymczasowe łączenie (bonding) lub rozłączanie (debonding) chipów i nośników podczas przetwarzania.
14. Redistribution Layer Structuring (RDL)
Laserowy proces strukturyzacji cienkiej warstwy metalu (warstwy redystrybucyjnej) przekazuje sygnały z chipa na zewnątrz i łączy ze sobą kilka chipów.
15. Marking
Lasery znakujące nanoszą numery seryjne, kody matrycowe lub logo na chipie i obudowie.
16. Laser Depanneling
Promień lasera oddziela poszczególne chipy, moduły lub elementy płytek obwodu drukowanego od większego zespołu (panelu).

