The key laser applications in semiconductor manufacturing
Discover our infographic, which clearly illustrates the key role of laser technologies in semiconductor manufacturing, from the silicon crystal to the finished microchip. In the front end, laser processes can assist with the cutting, exposure, etching, doping and smoothing of the wafers, while precise laser measurements help to ensure quality. In the back end, lasers can be used for separating, connecting, structuring and marking the chips. The illustration clearly shows how chip manufacturers can use lasers as a tool for maximum precision, efficiency and quality in a wide range of processes.
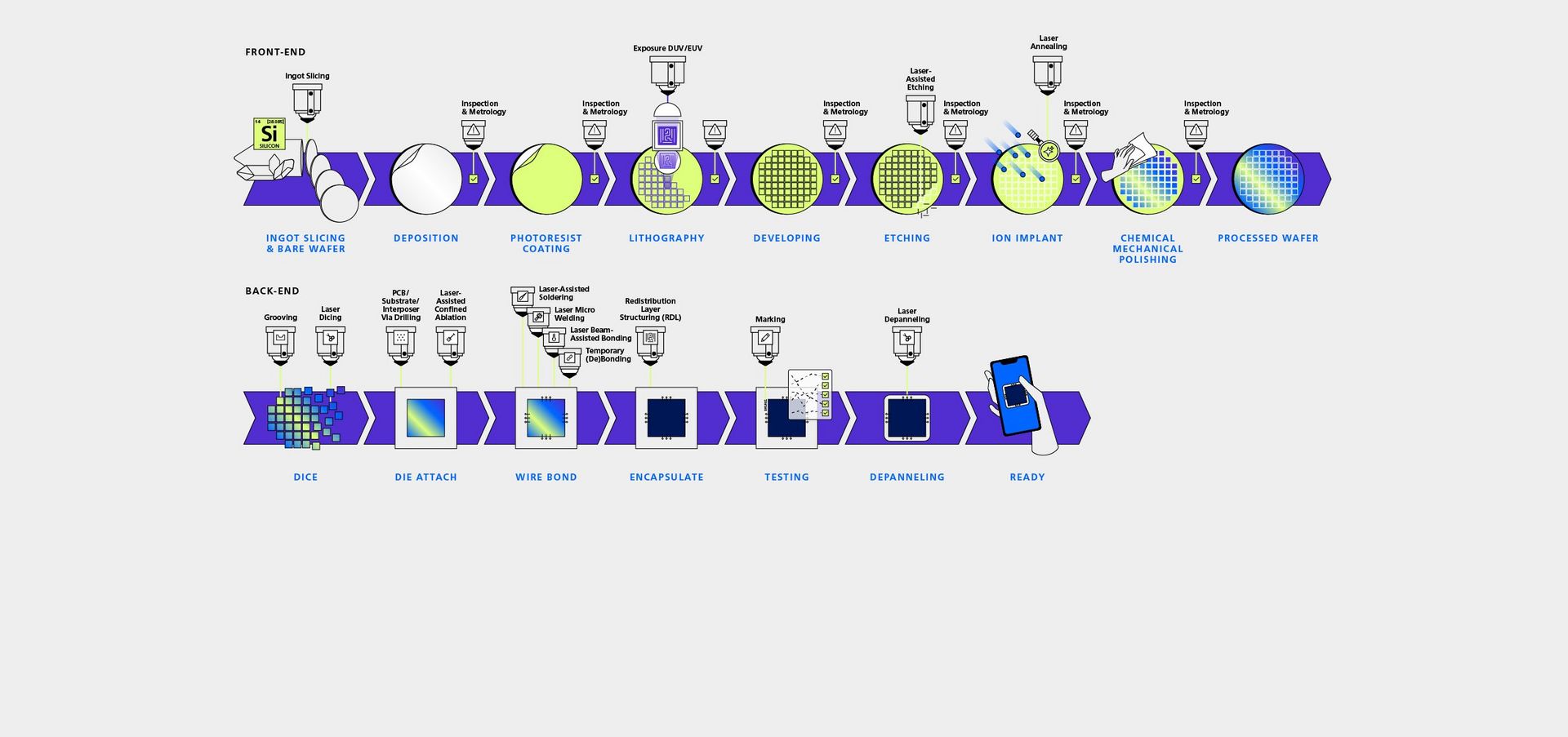
1. Ingot slicing
A laser cuts the single-crystal silicon into ultra-thin wafers without wasting any material.
2. Inspection & metrology
Non-contact laser measurement and fault detection ensures quality and process control after almost every step in the foundry.
3. DUV/EUV exposure
Lasers are required to provide deep ultraviolet (DUV) or extreme ultraviolet (EUV) radiation for the exposure process.
4. Laser annealing
The laser selectively heats areas close to the surface of the wafer for a few nanoseconds. This repairs crystal defects and activates dopants.
5. Laser-assisted etching
The laser heats specific areas to accelerate local etching. This is particularly helpful for complex shapes.
6. Grooving
The laser cuts fine grooves into the wafer or substrate material. This reduces the mechanical stress during subsequent dicing and increases the yield.
7. Laser dicing
A laser beam cuts the wafer into individual chips (dies) without leaving any particles. Laser processes are frequently used for ultra-thin wafers.
8. PCB/substrate/interposer via drilling
Lasers drill tiny vias into printed circuit boards, substrates and insulation layers. They enable vertical connections of circuit levels in 3D chips.
9. Laser-assisted confined ablation
The laser selectively removes surface material, for example to expose contact points that are difficult to access.
10. Laser-assisted soldering
The laser heats up tiny solder joints, connecting the chip to the substrate.
11. Laser micro welding
Laser beams melt fine wires at specific points, which welds the contact points together.
12. Laser beam-assisted bonding
The laser prepares the thermocompressive joining of chip and substrate or housing through targeted heat input.
13. Temporary (de)bonding
The laser supports the necessary temporary bonding or debonding of chips and substrates during processing.
14. Redistribution Layer Structuring (RDL)
The laser structures the thin metal layer (redistribution layer) that carries signals from the chip to the outside and connects several chips together.
15. Marking
Marking lasers apply serial numbers, Data Matrix Codes or logos to the chip and housing.
16. Laser depaneling
The laser beam separates individual chips, modules or printed circuit board components from a larger assembly (panel).

