Най-важните приложения на лазери в производството на полупроводници
Открийте нашата инфографика, която нагледно показва ключовата роля на лазерните технологии в производството на полупроводници, от силициевия кристал до готовия микрочип. В началната фаза на обработката лазерните процеси могат да съпътстват рязането, експозицията, ецването, легирането и полирането на пластините, докато прецизни лазерни измервания осигуряват качеството. В крайната фаза на обработката лазерите могат да осигурят разделянето, свързването, структурирането и надписването на чиповете. Изображението пояснява как производителите на чипове могат да използват лазери като инструмент за максимална прецизност, ефективност и качество в многобройни процеси.
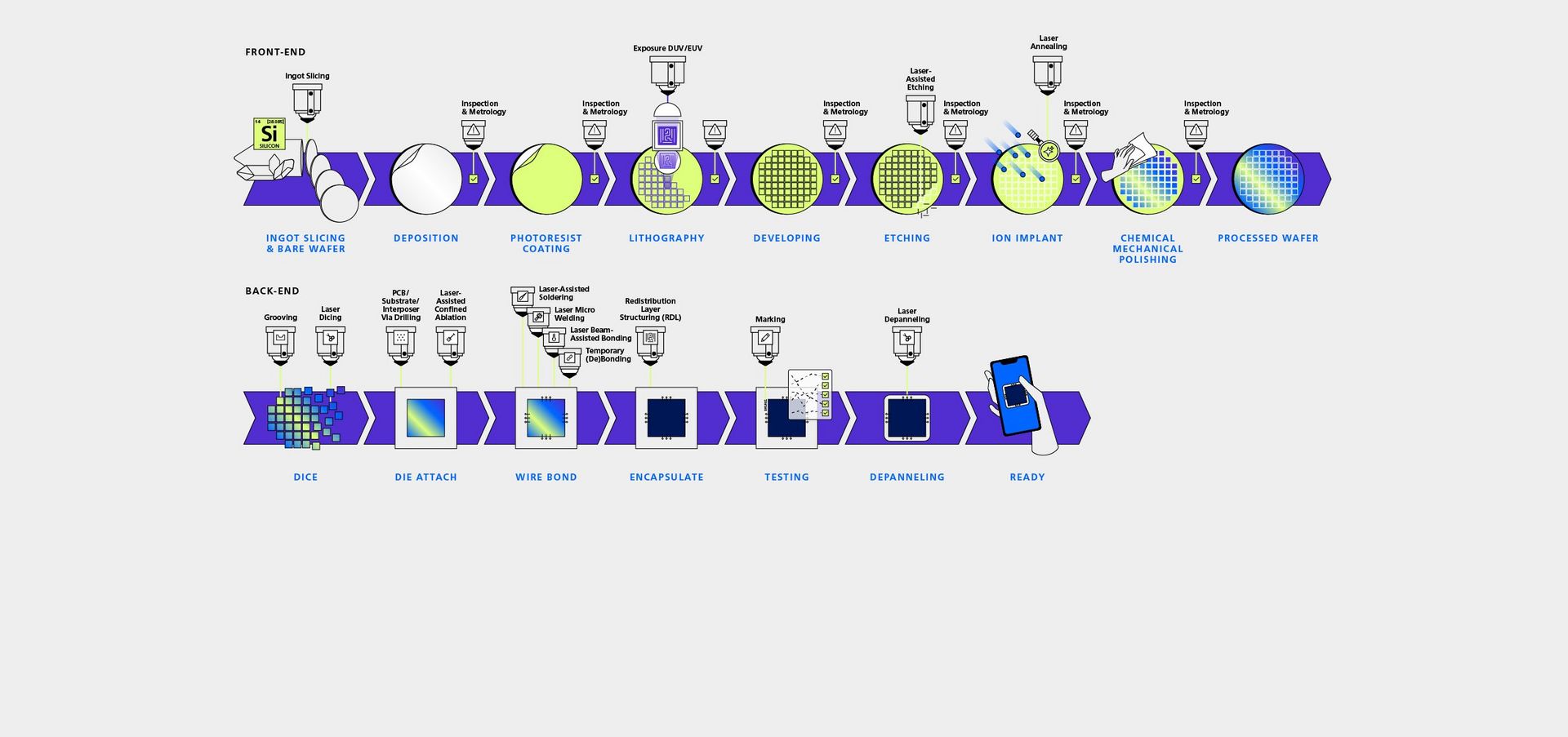
1. Ingot Slicing
По щадящ за материала начин лазер разрязва силициев монокристал на изключително тънки пластини.
2. Inspection & Metrology
Безконтактното лазерно измерване и откриване на грешки осигурява качество и контрол над процеса след почти всяка работна стъпка в производството на пластини.
3. Exposure DUV/EUV
Лазерите са нужни, за да осигурят дълбоко ултравиолетово лъчение (DUV) или екстремно ултравиолетово лъчение (EUV) за процеса на облъчване.
4. Laser Annealing
Лазерът нагрява избирателно в продължение на няколко наносекунди близки до повърхността зони на пластината. Това отстранява дефектите в кристалите и активира легиращите примеси.
5. Laser-Assisted Etching
Лазерът нагрява определени зони, за да ускори локалното ецване в тях. Това е особено полезно при сложни форми.
6. Grooving
Лазерът изрязва фини улеи (Grooves) в материала на пластината или субстрата. Това намалява механичния стрес при последващото разрязване и повишава производителността.
7. Laser Dicing
Лазерен лъч разрязва пластината на отделни чипове (Dies). Лазерни методи се използват особено често при много тънки пластини.
8. PCB/Substrate/Interposer Via Drilling
Лазерни лъчи пробиват микроскопични метализирани отвори (Vias) в печатни платки, субстрати и изолационни слоеве. Те позволяват вертикални връзки на нивата на интеграция в 3D чипове.
9. Laser-Assisted Confined Ablation
Лазерът целенасочено отнема повърхностен материал, напр. за да оголи труднодостъпни контактни точки.
10. Laser-Assisted Soldering
Лазерът нагрява микроскопични спойки и свързва с тях чипа и носещия елемент.
11. Laser Micro Welding
Лазерни лъчи стапят точково фин тел и с него заваряват контактните точки.
12. Laser Beam-Assisted Bonding
Лазерът подготвя термокомпресионното свързване на чип и субстрат или корпус чрез целенасочено въвеждане на топлина.
13. Temporary (De)Bonding
Лазерът помага за необходимото временно свързване (Bonding) или разделяне (Debonding) на чипове и носители по време на обработката.
14. Redistribution Layer Structuring (RDL)
Лазерът структурира тънкия метален слой (Redistribution Layer), който провежда сигнали от чипа навън, и свързва един с друг няколко чипа.
15. Marking
Маркиращи лазери нанасят серийни номера, матрични кодове (Data Matrix Code) или лога върху чипове и корпуси.
16. Laser Depanneling
Лазерен лъч разделя от по-голям пакет (панел) отделни чипове, модули или компоненти за платки.

